삼성전자 파운드리 사업 투자로 인해 최근 반도체 후공정 관련주들이 주목받고 있음. 반도체 후공정 시장 파이는 테스트와 패키징 분야로 나뉜다. 이전에 반도체 테스트 공정에 대해 정리했는데, 오늘은 패키징 공정에 대해서 작성해본다. 패키징 공정과, 테스트 공정 둘 다 보는게 반도체 후공정 과정을 이해하는데 도움이 될겁니다.
https://hogo55.tistory.com/m/11
반도체 테스트 공정과 관련주
반도체 테스트 공정 알아보기 반도체 테스트 사업은 단순히 양품 및 불량품 선별에 국한되는 것이 아니라 테스트 과정을 통해 확보된 데이터를 기반으로 수율 분석이나 불량 원인 분석에 대해 F
hogo55.tistory.com
국가별 패키징 업체들
한국의 삼성전자 파운드리 사업부는 그동안 내부 고객 매출이 대부분이었다. 삼성전자 IM사업부, 삼성디스플레이가 의뢰한 DDI, PMIC, CIS를 주로 생산했고 반도체 패키징 관련주들도 주로 스마트폰 시장과 연관되었다. 그래서 국내 패키징 업체들은 스마트폰 시장 업황에 민감했다.
참고로 국내 패키징 업체들은 대부분 테스트 영업도 같이하는데 이익 마진은 테스트 영업이 패키징 영업보다 크다.

반면 대만 업체들은 주로 CPU, GPU 등의 제품을 패키징, 테스트해서 PC, 서버 시장 업황에 민감했다.
특히 고사양 CPU, GPU를 위탁생산하는 TSMC가 있는 대만에는 반도체 후공정 세계 점유율 1, 2위 업체인 ASE, Amkor 등이 있다. 대만 반도체 산업은 태생부터 파운드리 모델을 지향해서 생태계가 잘 구축되어 있다.
DDI, PMIC, CIS 특징
DDI(Display Driver IC)는 디스플레이 구동 반도체이며 디스플레이가 고해상도가 되거나, OLED가 탑재되면 성능이 3배 이상 업그레이드 되어야한다. 참고로 DDI는 스마트폰에 1대씩 탑재되고, 폴더블 스마트폰에는 추가로 탑재된다.
PMIC(Power Management IC)는 스마트폰 전원을 관리하는 반도체, PMIC는 스마트폰에 4~5개 정도 탑재되며, 5G 스마트폰에는 최소 1개 이상이 더 탑재될 것으로 예상된다. 특히 전기차에도 PMIC가 다수 탑재되는데 시장이 커지면서 PMIC 시장 확대도 기대된다.
CIS(CMOS Image Sensor)는 이미지 센서이며, 카메라 모듈에 탑재되는 반도체. 최근엔 크기가 점점 작아지고, 픽셀의 크기가 작아지는 등 상향평준화가 이루어지고 있다. 그리고 자율주행모드가 상용화되면서 이미지 센서 수요가 증가하고 있는 점이 포인트.
패키징 공정 필수 부품 IC기판(Substrate)
IC기판은 복잡한 IC와 단순한 PCB 사이의 배선을 정리해주고 발열 현상을 줄여줄 중간기판(Substrate)이 필요하다는 생각에 만들어진 제품이다. 초기에는 CPU, GPU에만 사용되었으나 스마트폰 시장이 개화되면서 모바일용 AP에도 사용되었다.
그러던 중 2015년에 개발된 TSMC의 FO-WLP(Fan Out-Wafer Level Package) 기술은 Substrate이 필요없는 기술. 2010년 들어서면서 소비자의 스마트폰 구매가 증가하면서 반대급부로 PC 구매가 감소. 이렇게 되면서 PC제품에 주로 사용되던 IC 기판 산업에 위기가 찾아오게 되었다.
하지만 최근들어 GPU 사용 증가, CPU 패키징 로드맵 변화로 IC 기판 사이즈가 매년 평균 20% 이상 커지게 되었다.
또한 IC 기판 회사들이 감소하면서 CPU, GPU IC 기판을 생산할 수 있는 회사는 고작 6개 밖에 없었다. ABF(아지노모토적층막)이라는 원재료와 리소그래피 장비를 공급받는게 어렵게 되면서 진입장벽이 형성되었고, 거대 고객사들과 레퍼런스 이슈도 신규 진입사에겐 부담이 되었다.
이렇게 수요는 증가하는 상황에서 공급이 타이트해지면서 IC 기판 산업은 호황기에 들어섰고, PCB 업체들은 경쟁적으로 공급설비 증설을 시도하고 있다.
https://n.news.naver.com/article/015/0004444358?lfrom=kakao
[중화권 주식이야기] 반도체 IC기판 부흥 이끄는 유니마이크론
한국경제신문은 앞으로 중화권 해외 주식 전문가의 기고를 연재합니다. 해외 주식에 대한 투자자 관심이 미국을 넘어 중국 등 아시아 전반으로 확대되는 추세에 부응하기 위해서입니다. 기고를
n.news.naver.com
IC 기판은 패키징 공정에서 쓰이는 부품인데 보통 Substrate으로 불리며 각 반도체 제품마다 사용되는 Substrate, 패키징 공정이 다르다.
FC(Flip-Chip)계열은 Bump라 불리는 Ball을 사용해 반도체 Chip과 PCB를 연결하고 그외에는 Wiring Bonding을 사용합니다.


WLP(Wafer Level Package) & PLP(Panel Level Package)
고성능 CPU, GPU, AP에 적용되는 WLP, PLP 기술이 Substrate을 사용하지 않은 패키징 기술인데 WLP는 TSMC가 삼성전자의 아이폰 AP 물량을 전부 빼앗게 해준 기술이고, PLP는 삼성전자가 이에 맞서 준비하는 패키징 기술이다.
이론적으로 보드/캐리어의 면적 효율성은 PLP가 WLP 대비 더 뛰어나다. WLP 보드/캐리어(원형)에 Good Die 배치 시 사각지대(Dead Space)가 발생하지만 PLP 보드, 캐리어(직사각형)에 배치 시 사각지대 없이 배치 가능하다.
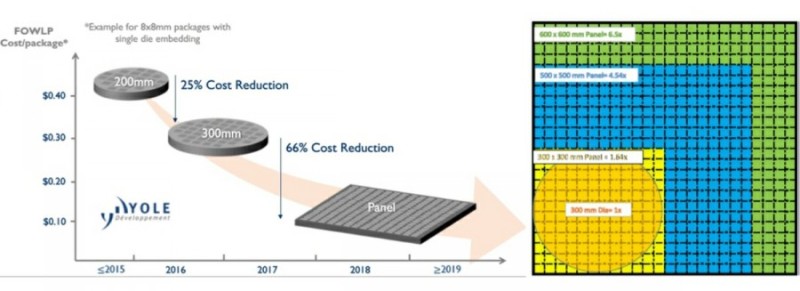
그러나 WLP는 오래전부터 표준화된 기술이지만 PLP는 직사각형, 정사각형 등 다양하여 아직 표준화되지 않은 기술이다.
또한 WLP는 칩을 배열할 때 전통적인 Dispensor 장비를 사용하지만 PLP는 Pick & Placement 장비를 이용합니다. 쉽게 말하자면 WLP 기술을 기존 설비로 대응 가능하지만 PLP 기술을 설비를 추가해야 되는 번거로움이 있다.
2015년 TSMC는 FO-WLP를 먼저 양성했고, InFO(Integrated Fan-Out)이라는 브랜드로 자리잡았다. InFO 후공정 기술은 16nm SoC와 DRAM에 적용하였고, AP 양산에 적용을 성공한 뒤 대규모 양산은 2016년 상반기부터 시작했다.
2019년 6월 1일, 삼성전기가 운영했던 PLP 사업 일체를 삼성전자가 7850억원을 주고 양도받았다. 현재 PLP 기술은 PMIC, AP 등에 적용 가능한 상태이고, 주로 Wearable 기기용 AP에 적용되는 것으로 추정됩니다.
어디에 투자해야 되는가?
삼성전자 파운드리 사업부가 커질수록 반도체 패키징 관련주들이 수혜를 받을 것으로 전망되며 주가가 많이 상승했다. 하지만 국내 반도체 패키징 업체는 DDI, PMIC, CIS 패키징 서비스를 주로 다루었고 CPU, GPU, AP 후공정 서비스는 대만 후공정 업체가 더 우세하다.
삼성전자가 외부 고객(CPU, GPU, AP)을 유치할수록 당분간은 대만 후공정 업체들이 수혜를 보지 않을까요? 그리고 고성능 제품들은 대형 파운드리사에서 직접 후공정 서비스를 제공하는 점도 패키징 업체에겐 위험요인이다.
밸류에이션을 보았을 때도 반도체 패키징 관련주들이 그리 매력적이지 않았다. 국내에서 PCB 선도 업체인 삼성전기, LG이노텍은 나름 해외 PCB 업체와 견줄만한 경쟁력을 지니고 있지만, 메인 매출원이 PCB가 아니며 밸류에이션도 조금 비싼감이 있다.
차라리 대형 파운드리회사 TSMC, 삼성전자 or 후공정 투자에 수혜를 받을 장비, 테스트 부품사들이 더 낫다고 본다.
'산업 > 반도체, 디스플레이 산업' 카테고리의 다른 글
| 반도체 OSAT 관련주, 에이팩트 윈팩 주가 전망 (0) | 2021.09.25 |
|---|---|
| 반도체 장비 관련주 정리 (0) | 2021.09.15 |
| 반도체 테스트 공정과 관련주 (0) | 2021.08.30 |
| 반도체 공정용 특수가스 (0) | 2021.08.20 |
| 반도체 공정용 화학제품(Chemical) (0) | 2021.08.14 |




댓글